에칭에 이어 이번 포스팅은 증착공장 및 이온주입 공정에 대한 내용이다 😊
👇🏻👇🏻에칭포스팅은 아래 링크를 참고하면 된다. 👇🏻👇🏻
진짜 하루만에 이해하는 반도체 산업 - Part3 8대 공정 4. 에칭공정
👇🏻👇🏻이번 포스팅은 에칭공정이다. 지난편 포토공정은 아래 링크 👇🏻👇🏻 진짜 하루만에 이해하는 반도체 산업 - Part3 8대 공정 3. 포토공정 👇🏻👇🏻지난번 산화공정에 이어 이번
dudwolog.tistory.com
증착공정 Deposition 및 이온주입공정 Ion Implantation
1. 증착공정이란?
물질을 얇은 필름의 형태로 만들어 원하는 위치에 씌우는 것을 말한다. 또 다른 말로는 박막공정 이라고도 한다.
공정이 진행될수록 절연막이 계속 필요한데, 산화공정으로는 원하는 모든 곳에 절연막을 형성할 수없다. SiO2절연막을 만들기 위해서는 웨이퍼에서 실리콘 원자를 공급받아야 하는데, 공정을 진행하다 보면 실리콘 원자를 공급받기 어려운 위치가 생긴다. 또, 반도체 소자가 만들어진 후 산화공정을 진행하면, 높은 온도와 산화 반응으로 인해 반도체 소자와 금속 배선들의 특성이 열화되는 문제도 있다. 이러한 이유로 공정이 진행되는 과정에서 산화공정으로 절연막을 만들기가 어렵다.
그래서 산화공정으로 형성하는 이산화규소 절연막 대신, 증착공정을 활용해 절연막을 만든다.
증착공정은 증착하려는 물질의 재료를 모두 기체나 순수한 고체 상태로 공급하기 때문에 표현의 상태와 무관하게 원하는 필름을 형성할 수 있다. 또, 산화공정에 비해 공정온도가 낮아 더 많은 상황에 활용할 수 있다.
증착 공정을 통해 형성되는 박막은 용도에 따라 두께가 조금씩 달라지는데 보통 1마이크로미터 미만이다. 박막으로 사용하는 증착 물질의 종류도 사용 목적과 역할에 따라 수없이 많이 존재한다.
예를 들어, 반도체 소자와 소자를 연결하기 위한 금속 도선을 형성할 때에는 금속 박막을, 도선과 도선 그리고 소자와 소자 사이의 절연이 필요할 때에는 절연막을 증착하는 방식이다. 반도체를 작게 만든다는 것은 가로 세로 방향 즉, 면적만 작은 것이 아니라 높이 방향인 두께도 얇아지는 것을 의미한다. 결국 증착 공정에서는 박막을 얇게 형성하는 것과 이 박막을 웨이퍼 전체 면적에 최대한 균일하게 입히는 것이 중요하다. 박막을 형성하는 방법은 크게 물리적증착 PVD (Pyysical Vapor Deposition)과 화학적증착 CVD (Chemical Vapor Deposition)으로 나누어진다.
2. 물리적증착 PVD
PVD는 물리적인 에너지를 이용해 박막을 형성하는 방법으로 화학적 반응 없이 진행되는 증착 공정이다. 운동에너지, 열에너지, 전기에너지 등을 활용해 재료 물질을 웨이퍼 위로 이동시켜 얇게 씌운 것으로 이해하면 된다. 대표적인 PVD방법으로는 #스퍼터링공정 (Sputtering), #열증발공정 (Thermal Evaporation), #전자빔증발 (E-Beam Evaporation)공정 등이 있다. 이 공정들은 박막에 이물질이 들어가는 것을 방지하기 위해 모두 진공 상태에서 진행 된다.
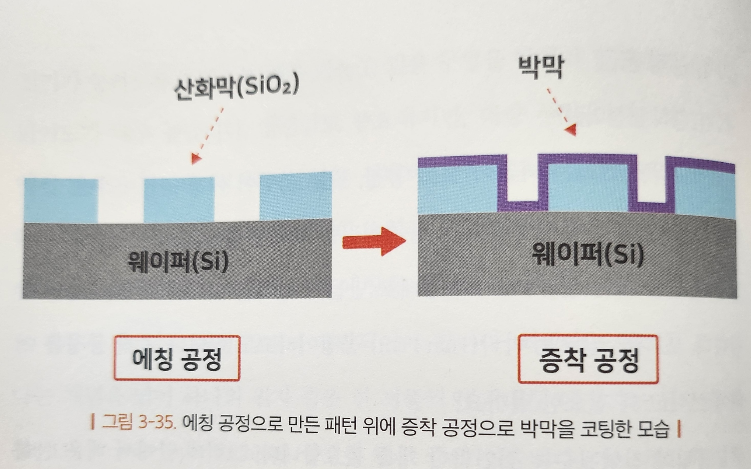
- 스퍼터링공정 : 플라즈마에너지를 이용해 박막 재료를 잘게 쪼갠 후, 이 파편들을 웨이퍼 표면으로 떨어뜨려 박막을 형성하는 방식이다.
- 증발공정 : 박막 재료에 열 에너지를 가해 증기 상태로 로만들어 코팅하는 방법이다. 히팅 코일이나 발열체로 열을 가할 경우 열증발공정 , 전자빔과 같이 전기 에너지를 이용해 가열할 경우 전자빔증발공정 이라 부른다.

PVD공정에서 사용하는 기체 상태의 파편이나 증기는 운동에너지를 가져 직진하려는 성질을 띈다. 과거에는 웨이퍼표면이 평평해서 박막의 두께를 균일하게 하는데 이러한 직진성이 큰 문제가 되지 않았다.
하지만 최근 들어 평평하지 않고 높이 차이가 있는, 즉 단차가 있는 3D 구조가 등장하면서 PVD공정을 통해 물질을 표면에 균일하게 코팅하는 데 어려움을 겪고 있다. 단차로 생긴 벽면과 바닥면에 얼마나 균일한 두께로 박막을 형성하느냐와 관련된 특성이 바로 단차피복성 (Step coverage) 이다. PVD는 단차피복성이 매우 좋지 않아 최신 반도체 공정에서는 금속재료증착 외에는 거의 활용하지 않는다. 또한 단위 시간당 처리량이 작아 그 활용도가 더 낮아지고 있다.

3. 화학적증착 CVD
CVD Chemical Vapor Deposition : 재료들을 가스 상태로 진공 챔버에 주입하고 열이나 플라즈마 에너지를 가하여 웨이퍼 표면에 박막을 증착하는 방법이다. 화학적 반응을 활용하는 CVD는 원재료 물질과 웨이퍼에 형성되는 최종 박막 물질이 서로 다르다. 재료가 되는 가스들 사이의 화학적 반응과 이 가스들이 웨이퍼에 닿으면서 생기는 화학적 반응으로 인해 새로운 물질이 박막 형태로 웨이퍼 표면에 성장되기 때문이다. 그래서 CVD에서 사용하는 재료를 "목표 물질이 되기 전 상태의 화학물질"이라는 의미를 가진 전구체 (Precursor) 라고 부른다. 전구체 가스가 도달할 수 있는 곳이라면 어디든지 필름을 씌울 수 있고, 단차피복성도 PVD 대비 매우 우수하다.
CVD는 현재 반도체 제작에서 주로 사용되는 증착 공정이며, 더 복잡한 구조에 더 균일한 두께의 박막을 더 빠른 시간에 형성하는 방향으로 기술 발전이 이루어지고 있다. 기술발전에 영향을 미치는 요소로는 원재료 물질의 종류, 에너지를 가하는 방법, 압력을 조절하는 방법 등이 있으며 요소에 따라 다양한 CVD방식이 개발되었다.
모든 CVD의 기본 원리는 다섯단계로 나타낼 수 있다.
1. 화학반응에 활용되는 전구체 가스가 진공 챔버로 확산되고,
2. 확산된 전구체는 웨이퍼 표면에 흡착된다.
3. 표면에 흡착된 전구체가 화학 반응을 일으키며 웨이퍼 전체에 필름을 형성한다.
4.반응하고 남은 부산물들이 표면으로부터 떨어져 나오면서
5. 진공챔버 바깥으로 확산되며 완전히 제거된다.
우리가 관심있게 살펴볼 부분은 전구체가 화학반응을 통해 웨이퍼 표면에 박막을 형성하며 확산되는 3번과정이다. 이 과정에서 화학반응을 일으키기 위한 에너지를 어떻게 공급할 것인지, 공정이 진행되는 환경의 압력은 얼마인지, 증착되는 박막의 형태가 어떤지에 따라 다양한 기술로 구분된다. 화학 반응에 필요한 에너지를 열로 공급하면 열CVD Thermal CVD, 플라즈마로 공급하면 플라즈마CVD Plasma CVD이다. 열CVD는 다시 대기압 수준에서 진행되는 APCVD Atmospheric Pressure CVD와 이보다 낮은 압력에서 진행되는 LPCVD Low Pressure CVD로 나뉜다. 고품질의 필름을 형성하기 위해서는 최대한 압력을 낮추는 것이 좋지만, 압력이 낮아질수록 공정 온도가 높아지는 것을 고려해야 한다. 공정 온도가 한계치 이상으로 높아지면 반도체 소자의 동작 특성이 달라지거나 금속 도선이 녹는 등의 문제가 생길 수 있기 때문이다.
플라즈마CVD 는 플라즈마를 이용해 온도를 크게 높이지 않으면서도 큰 에너지를 가할 수 있어 저온에서도 고품질의 박막을 빠르게 증착할 수 있다. 대신 플라즈마 생성을 위해서는 낮은 압력의 환경이 필요하다. 플라즈마CVD는 LPCVD보다 저압에서 진행하는 저밀도플라즈마CVD PECVD Plasma Enhanced CVD와 그보다 더 저압의 환경(=고밀도)에서 진행되는 고밀도플라즈마CVD HDPCVD High Density Plasma CVD로 분류된다. 현재는 고밀도의 플라즈마를 활용한 HDPCVD가 주로 사용되고 있다.
이렇게 CVD는 낮은 압력과 낮은 온도를 갖춘 환경을 조성해 고품질의 박막을 더 빠르게 형성하는 방향으로 발전해왔다. 하지만 반도체 구조가 점점 더 복잡해지면서 CVD공정 역시 단차 피복성 측면에서 한계를 맞이했다. 이 한계를 극복하고자, 공정의 기본 원리는 비슷하지만 원자층을 하나씩 켜켜이 쌓는 방식인 #원자층CVD #ALCVD #ALD Atomic Layer Deposition 이라는 공정이 개발되었다.
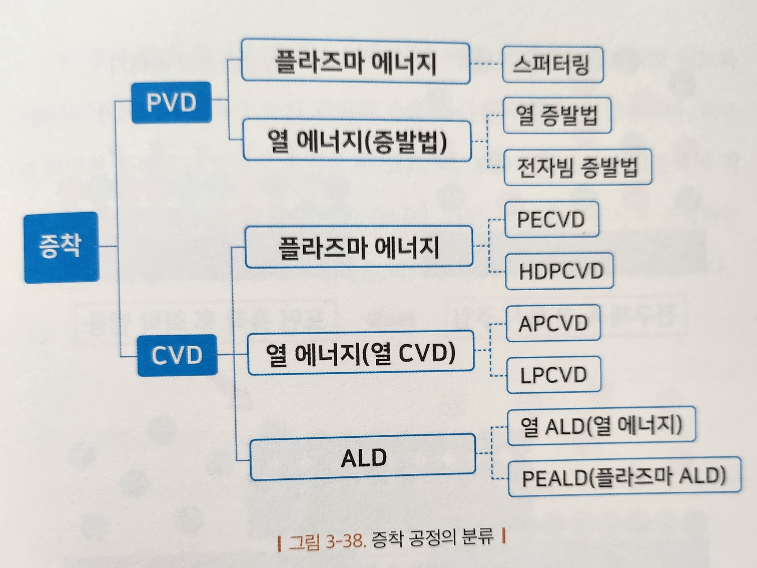
4. ALD 원자 단위 필름 증착
ALD역시 화학적 반응을 활용한다는 점에서 기본적으로 CVD와 결을 같이 하지만, 전구체를 공급하는 방식에는 큰 차이가 있다. CVD가 박막 증착에 쓰이는 모든 전구체를 동시에 공급하는 반면, ALD는 전구체를 하나씩 차례로 공급하여 박막 물질이 한 회(사이클)에 한 층씩 쌓이도록 진행한다.
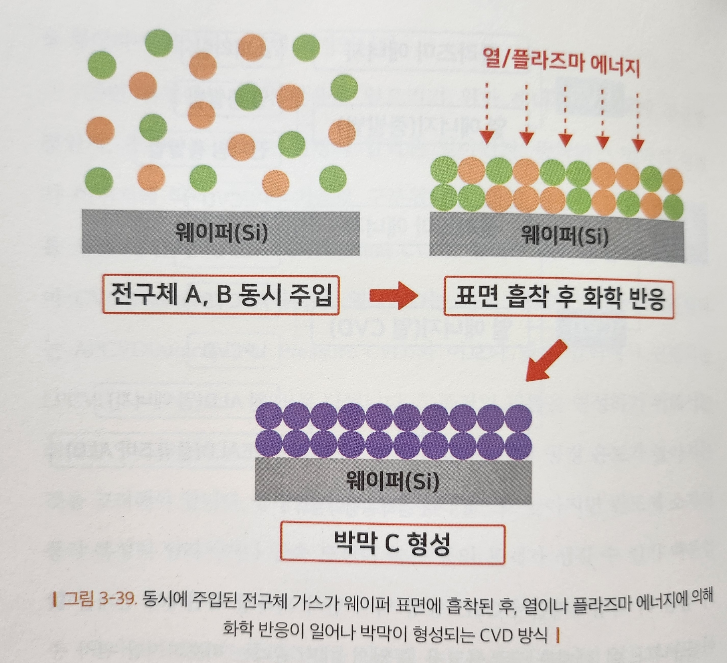
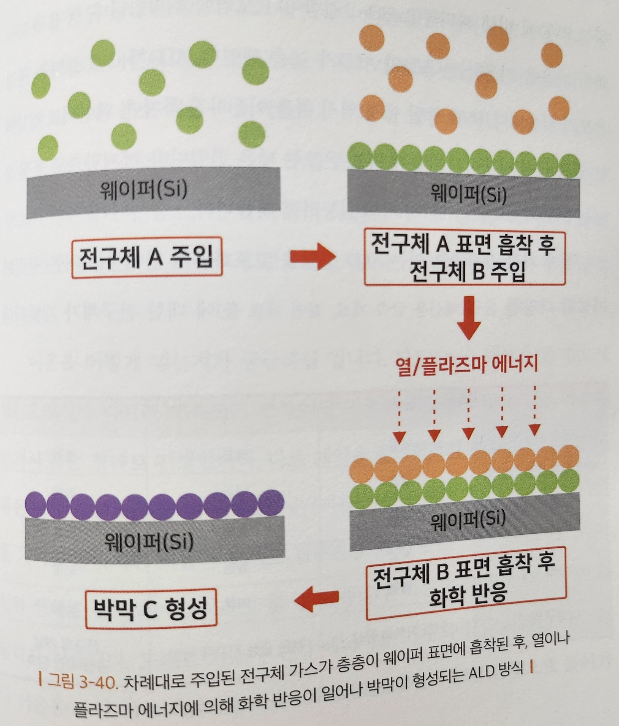
이 그림이 ALD를 설명한다. ALD에서는 먼저 A만 주입해 웨이퍼 표면에 한 층을 코팅하고, 그 위에 B를 공급해 또 한층을 형성한다. 그래서 A와 B가 서로 반응을 일으켜 C가 증착이 되는 것. 이 과정이 ALD 증착의 한 사이클이다. 한층이 얇게 형성된 후에는 표면에 더 이상 전구체가 흡착되지 않도록 제어가 가능해 원자 혹은 분자 단위의 층을 하나씩 형성할 수 있다. 덕분에 박막의 두께를 정밀하게 조절할 수 있다. 즉, ALD를 활용하면 고품질의 박막을 매우 얇은 두께로 형성할 수 있다. 다만, 전구체를 동시에 공급하는 CVD에 비해 증착 속도가 느려 두꺼운 박막을 증착하는 데 한계가 있다.
증착공정의 발전 방향
박막 두께는 더 얇아져야 하고, 복잡한 3D 구조에서도 균일한 두께를 유지해야 하며, 다른 소자와 열화 되지 않도록 저온에서 공정이 진행되어야 한다. 현재 단차 피복성이 가장 뛰어난 공정은 ALD이다. 그다음이 CVD. 다만, 화학반응을 기반으로 하는 ALD와 CVD는 물리적인 방법을 이용하는 PVD에 비해 파티클결함이나 오염에 취약하다. 공정온도는 화학반응을 이용하는 CVD와 ALD가 높은 편인데, ALD가 CVD보다는 공정온도가 낮다. PVD 증발공정 역시 열을 이용하긴 하지만, 웨이퍼로 전달되는 열을 극히 일부이기 때문에 공정온도는 낮은 편이다. 마지막으로 공정 속도는 PVD와 CVD가 ALD에 비해 월등하게 빠르다. 현재 가장 각광받고 있는 ALD 공정을 고도화하기 위해서는 저온공정이 가능한 다양한 물질(배선용 금속재료, 절연재료 등)에 대한 전구체가 개발되어야 한다. 또, 한 사이클에 소요되는 시간을 단축시킬 수 있는 장비와 공정의 개발 역시 필요. 궁극적으로 증착 공정은 기존 재료의 한계를 뛰어넘기 위해 새로운 재료를 개발하는 방향으로 끊임없이 발전해 나갈 것이다.

이온주입공정 Ion Implantation
1.이온주입공정이란?
웨이퍼에 이온을 주입하는 공정이다. 이온주입공정에서 뜻하는 이온이 바로 도펀트 원소의 이온이다. 붕소, 인, 비소 등의 도펀트 이온을 실리콘 웨이퍼에 주입해 전기가 통하는 P형 혹은 N형 반도체로 만드는 공정이 바로 이온주입공정 이다.
이온을 어케 넣을까? 다트와 같다. 도펀트 가스에 전기에너지를 가해 주입할 이온을 만들고, 이 이온을 다시 전기 에너지로 가속시켜 실리콘 웨이퍼 표면 안쪽으로 들어가도록 하는 원리이다. 실리콘웨이퍼가 코르크점수판, 주입하려는 이온이 다트 바늘인 셈. 📌
이온주입공정에서 중요한 것은 원하는 양의 도펀트 이온을 필요한 영역에만 정확히 주입하는 것이다.
이를 위해 이온을 가속하는데 사용하는 전압과 이온 빔 전류를 조절하고, 표면의 산화막을 이용해 이온이 들어가지 말아야 할 영역을 구분해준다.
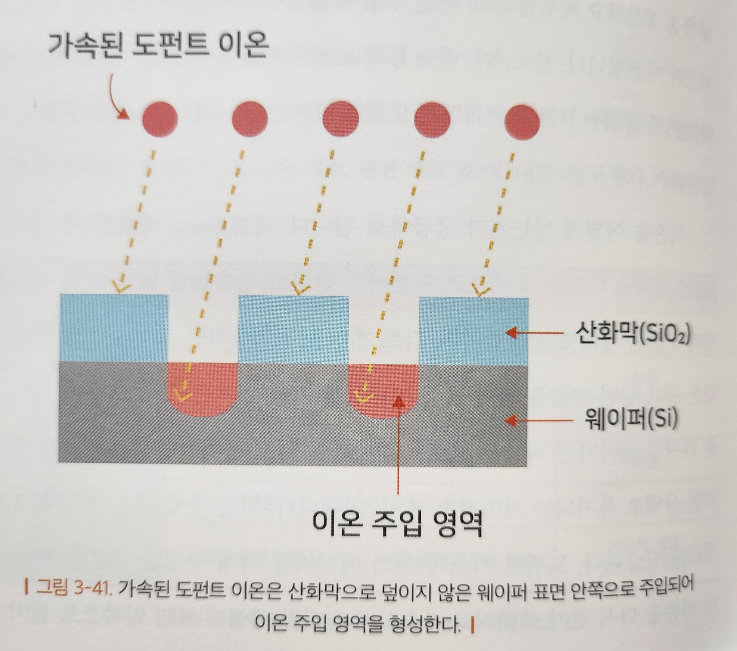
가속된 이온들을 실리콘 원자 사이의 결합을 끊거나 격자 사이의 틈을 비집고 들어가 웨이퍼 표면 내부에 안착한다. 이때, 주입된 된원자들이 웨이퍼 내에서 실리콘 원자들과 공유 결합을 잘 형성할 수 잇도록 이온 주입된 실리콘 웨이퍼를 400~1000'C온도에 노출시킨다. 이렇게 열처리 Thermal Annealing 또는 급속열처리 #RTA Rapid Thermal Annealing 과정까지 거치고 나면 비로소 실리콘 웨이퍼의 도핑이 완료된다.
2. 이온주입공정의 발전 방향
반도체 소자의 크기가 점점 작아지고 있다. 이는 곧 이온주입 과정에서 발생하는 물리적인 결정의 손상이 반도체 소자에 더 큰 영향을 미친다는 것을 의미한다. 소자가 작아져 공정 온도에 민감한 만큼 열처리 과정에서도 문제가 생길 수 있다. 결국 이온 주입 공정에서 피할 수 없는 물리적인 손상을 최소화할 수 있는 공정을 설계하거나 이를 대체할 수 있는 공정의 개발이 필요하다.
'반도체공부' 카테고리의 다른 글
| 진짜 하루만에 이해하는 반도체 산업 - Part3 8대 공정 7. 테스트공정 (0) | 2023.09.14 |
|---|---|
| 진짜 하루만에 이해하는 반도체 산업 - Part3 8대 공정 6. 금속배선공정 (0) | 2023.09.14 |
| 진짜 하루만에 이해하는 반도체 산업 - Part3 8대 공정 4. 에칭공정 (2) | 2023.09.09 |
| 진짜 하루만에 이해하는 반도체 산업 - Part3 8대 공정 3. 포토공정 (1) | 2023.09.06 |
| 진짜 하루만에 이해하는 반도체 산업 - Part3 8대 공정 2. 산화공정 (0) | 2023.09.04 |